凡事有好有坏,光模块封装技术也不例外
ICC讯 知名光模块制造商深圳市恒宝通光电子股份有限公司副总经理叶宇博士分享了他对于数据中心光模块COB封装技术优劣势和后续封装发展趋势。
光模块(图1)是光通信系统中的重要部件,主要作用是实现光电信号的相互转化,附带通信信号的监控管理等功能。在光纤网络遍布的今天,光模块的应用场景也越来越多。例如我们在用手机打电话时,手机信号和基站之间是无线电通信,从基站到服务器之间通过光纤链路连接,就需要用到光模块;光纤入户的宽带网络和数据中心内大量交换机的相互连接也需要用到光模块。

图1 恒宝通光模块实物图
光模块市场需求情况
据Lightcounting 预计,2022年全球光模块市场将达到81.32亿美元,预计2021~2026年的复合年增长率可能达到13.7%。其中数据中心应用光模块占比已经超过电信市场光模块,预计2022年占比达到55%以上。图2为光模块全球市场及资本开支情况分析。

图2 光模块全球市场及资本开支情况。(a)全球光模块市场应用领域情况;(b)中国云厂商资本开支情况 (图片来源:五矿证券)
数据中心整体资本支出仍在快速扩张。据Cignal AI长期预测,2021~2026年,计算和存储云基础设施支出的复合年增长率(CAGR)将达到12.6%。后疫情时代线上生活工作方式的变化、公有云(公有云是指第三方提供商通过公共Internet为用户提供的云服务,用户可以通过Internet访问云并享受各类服务,包括并不限于计算、存储、网络等。)巨头的全球扩张以及AI在各行业的快速落地发展下,数据中心投资保持着强劲势头,使得数据中心光模块市场景气度持续提升。
预计在“十四五”期间,我国大数据中心投资将以每年超过20%的速度增长,累计带动各方面投资将超过3万亿元。随着2022年2月“东数西算”工程的全面启动,在京津冀、长三角、粤港澳大湾区、成渝、内蒙古、贵州、甘肃、宁夏等8地将建设国家算力枢纽节点,并规划了10个国家数据中心集群。超大规模数据中心的建设将提供大量的光模块需求,也加快了数据中心光模块封装技术迭代更新速度。
与此同时,国内光模块厂家的市场占有率也在快速提升。据 Lightcounting 数据统计,从2010年到2020年,国内光模块厂家全球份额从16.8%提升到43.9%,据预测国产厂家 2022~2024 年市场占有率将每年增加3%。图3为光模块在电信市场及数据中心应用场景。

图3 光模块在电信市场及数据中心应用场景。(a)5G电信网络构架(图片来源:国联证券);(b)数据中心脊叶服务器构架
(图片来源:http://www.infiberone.cn)
根据应用场景和要求的不同,光模块大致可以分为电信级和数据中心光模块。前者应用的环境条件恶劣,更换维护困难;后者相对环境温和,维护便利。例如在室外基站上使用的电信级光模块,在日照强烈的时候可能面临80 ℃的高温工作环境,而在北方的冬夜环境温度可能低至零下40 ℃。同时,为了保障信号覆盖,这些基站可能处于山林等交通不便的地方,难以进行经常性维护。这些特点都决定了电信级光模块对可靠性保障的高要求。
反观数据中心应用场景,可能处于空调控温控湿的机房内,常驻维护人员可以随时进行检修,因此对可靠性要求相对较低。综合应用场景、要求、成本等多方面的考虑,演化出了不同的光模块封装技术。目前,电信级光模块多采用气密性的To-can或BOX(盒式)封装技术;数据中心光模块多采用非气密性COB封装技术,如图4。COB全称是chip on board,即板上芯片封装,将裸芯片用导电或非导电胶粘附在PCB上,然后进行引线键合实现其电气连接,并用胶把芯片和键合引线包封。该封装技术最早广泛应用于LED的封装,后来被引入光模块的封装。
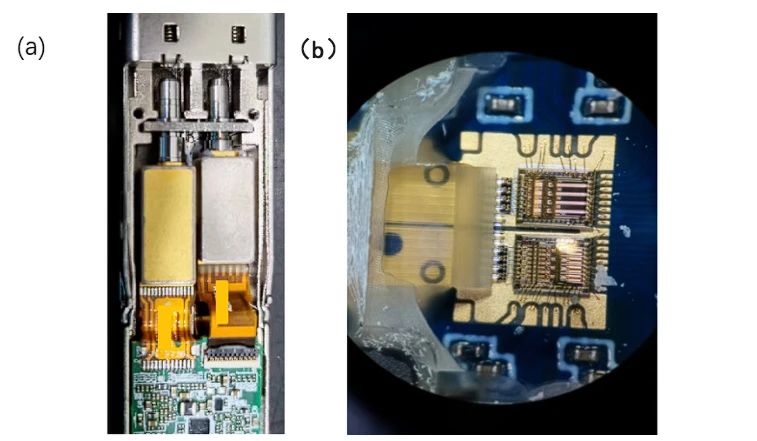
图4 (a)BOX封装光模块实物图;(b)COB封装光模块实物图
(1)更好的高速信号连接性能
采用气密性封装的电信级光模块,激光器与PCB的连接需要通过FPC(软排线)和高频陶瓷,然后才通过金线与激光器连接。在多个连接点上阻抗连续性难以保障,信号完整性损失在所难免。而在COB封装中,激光器能够直接与PCB通过金线键合连接,大大减少了阻抗不连续点,更好地保障了高速信号从PCB到LD的连接,进而表现为更大的眼图模板余量和更高的灵敏度性能。
(2)能够减小体积和成本
COB封装由于节省了高频陶瓷盒、软缆等部件,节约了空间。其优势在光模块不断追求更加小型化封装的今天更为明显。以采用EML激光器的400G QSFP-DD光模块为例(图5),需要DML偏置、EA偏置、EA调制、DSP等大量电芯片,光学部分需要EML、隔离器、透镜等元器件。如果采用气密性封装,光器件就会占据很大的空间,大大压缩电学器件的布置空间,给模块设计带来很大挑战。而使用COB封装,节约的空间能够给电学提高更多冗余设计,比如增加更多滤波电容、更大的高频信号隔离布局,从而提升模块性能。

图5 400G光模块实物图,小尺寸要求和大量元器件给封装设计带来挑战
从成本上看,COB封装节省了高频陶瓷盒和软缆等部件,工艺步骤上节省了充氮焊接密封、BOX检漏、FPC焊接、光器件单独检测等,能够减少物料成本和生产成本。
(1)敏感器件寿命降低
在COB封装中,光学器件和部分电芯片,如驱动器、TIA等直接暴露在环境中,导致使用寿命受到不利影响。而在气密性封装中,LD被密封在充满氮气的盒子中,与外界环境隔绝,更好地保障LD的稳定工作。
近几年,模块厂商也借鉴两种封装技术,开发了一些有限气密的技术来提升COB模块中LD的寿命。例如将LD贴装在半开口的金属盒中,PCB可以通过开孔进入金属盒中直接与LD连接,同时金属盒可以通过胶水密封,提供一定程度的密封性。
(2)不利于不良品返修
在BOX封装中,光器件能够完全与PCB分开制作,单独检测。任一部分出现问题都可以单独更换维修。
在COB模块中,由于光器件直接与PCB板连接,需要整体制作完成后才能进行性能测试。如果出现不良,排查是电芯片还是光芯片问题,更加困难,返修更换器件也更容易造成报废,可能出现一颗光芯片损坏,导致整个模块报废的情况,在一定程度上增加了整个生产过程中的报废率。因此,COB封装工艺中,工艺稳定性和良品率就显得尤为重要。
COB封装光模块的主要工艺步骤包括贴片(die bonding)、打线(wire bonding)、光学耦合、测试(图6)。

Die bonding,即用胶水贴装的方式将各类芯片固定在PCB上,例如数据中心光模块内的时钟恢复芯片、激光器驱动芯片、跨阻放大器芯片、激光器芯片、探测器芯片等,常用银胶直接贴装在PCB上。贴装中要注意位置精度是否满足要求、芯片粘接是否牢固等,对于激光器、驱动器功耗较大、发热量高的芯片,还需要关注贴片后接触散热性能情况。
wire bonding是指将芯片的引脚与PCB上的焊盘通过导线实现电气连接,通常使用金丝键合技术(图7)。该步骤要关注导线连接是否接触良好,有无虚接,常用引线拉力测试的方式来检查。在高速光模块中,往往线路复杂,需要大量的交叉打线,这时就需要注意是否有引线塌陷搭接等问题。对于高速信号引脚的连接,要注意引线的长度和数量,一般用减少引线长度、增加引线数量来提升信号的完整性。
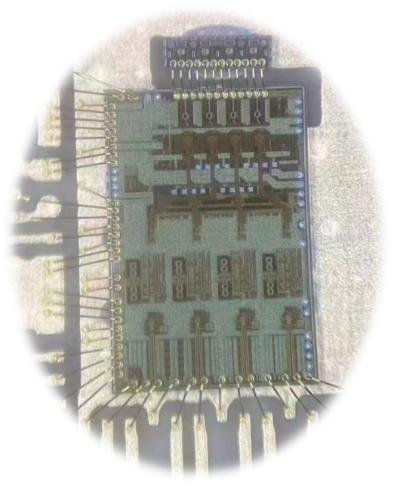
图7 COB封装中wire bonding实物图,通过金线将芯片焊盘与电路板焊盘连接
耦合(图8)是光模块封装中工时最长、最容易产生不良品的步骤。对多模光模块来说,普遍采用面发射激光器vcsel,经反射镜耦合进入多模光纤中。光路简单、容差大、工艺相对简单。对单模光纤则复杂的多,由于单模光纤纤芯直径比多模光纤小,只有9 μm,需要透镜进行聚焦耦合。在需要多路耦合的模块中,如LR4,还需要加入和分波元件,进一步加大了光路的复杂度。耦合需要用到的一个重要辅料是紫外固化胶,它主要用于粘接耦合透镜。其特点是胶水经紫外光照射后快速固化,收缩率低,适合对粘接固定精度有很高要求的准直耦合透镜使用。
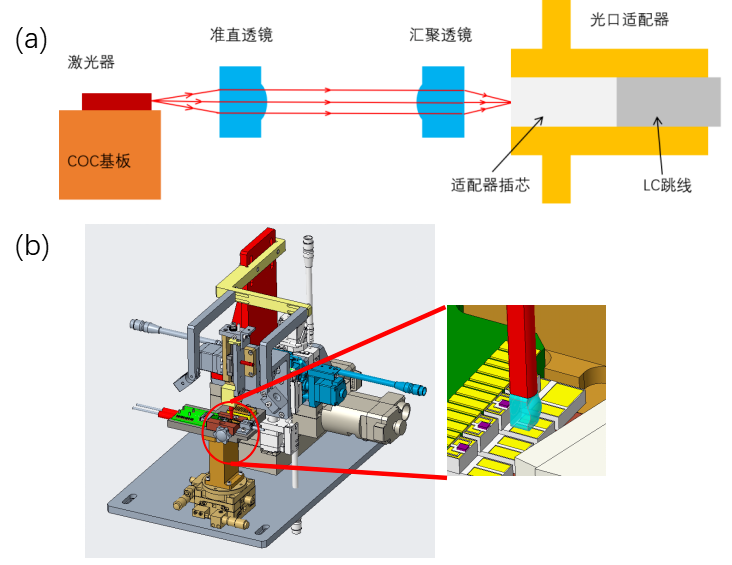
图8 COB耦合工艺。(a)双透镜耦合示意图;(b)恒宝通自主开发自动化耦合设备示意图
测试是光模块生产的最后步骤,主要分为性能测试和可靠性测试。常见的性能测试项包括眼图余量、消光比、发射功率、接收灵敏度等。可靠性测试项通常包括高低温带电老化测试、高低温循环冲击测试、振动测试、多次插拔测试等。
整体上看,数据中心光模块的需求趋势是更加小型化的封装、更高的传输速率和更低成本。目前,100G速率光模块在数据中心已经大量普及;400G速率光模块在国外大规模数据中心也已商用多年,国内数据中心也开始逐步引入;800G速率光模块正处于商用的早期阶段。面对更高速率的需求,传统光模块封装面临越来越多的困难,包括封装复杂的提升、良率降低导致成本加大、器件带宽受限等。在这一背景下,硅光模块、共封装光学(CPO)等新技术的商用化受到更多期待。
硅光在光模块中的应用旨在通过高度集成化的硅光芯片,将原本分立的光学元器件,如调制器、探测器、MUX/DeMUX、透镜、棱镜等集成在一起,达到简化工艺,降低成本目的。目前,硅光芯片已经能够将探测器、高速调制器、波导、合分波器等器件集成在同一硅基衬底上,预期将来还能够集成CDR、TIA等更多电芯片,大大提升光模块的集成度。
2022年,400G速率的硅光模块已经开始批量进入市场。市场研究机构Yole预测,到2025年,硅光模块将达到36.7亿美元,成为光模块市场的重要一部分。图9展示了各类硅光器件。
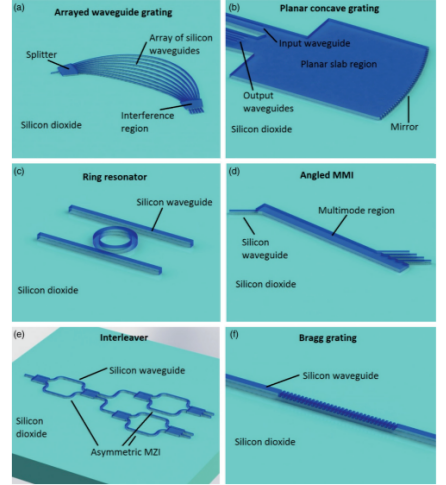
图9 各类硅光器件。(a)阵列波导光栅;(b)平板凹面光栅;(c)环形谐振器;(d)多模干涉器;(e)交叉复用器;(f)布拉格光栅 [1]
共封装光学技术(CPO)近年来也得到越来越多的关注,其在电气连接损耗上相比传统可插拔形式的光模块有很大优势。CPO技术通过将光电芯片和交换芯片共同封装在一起,大幅缩短高频走线的长度,从而解决了更高速率下电信号衰减严重的问题,也使得其在带宽、尺寸、重量和功耗等方面相较可插拔形式有着很大优势。
但CPO技术目前还有部分问题待进一步解决,包括高密度光电PCB板工艺、高精度的光电芯片封装工艺和散热设计、高度集成化光电芯片的可靠性等。CIR预测,2027年CPO市场收入有望达到54亿美元。图10为板上连接技术演进示意图。
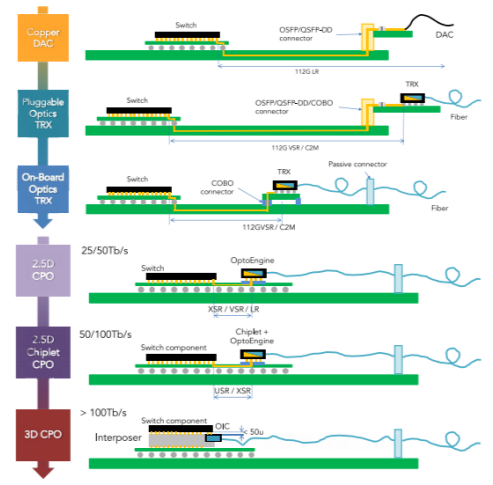
图10 板上连接技术演进示意图。从上至下:铜缆连接,可插拔光器件、板载光学器件、2.5D CPO封装、2.5D芯片级CPO封装、3D CPO封装[2]
参考文献:
[1] Tokuda, T., Ohta, J., Tashiro, H., & Terasawa, Y. (2018). Wiley Encyclopedia of Electrical and Electronics Engineering: Retinal Prosthesis. In J. Webster (Ed.), Wiley Encyclopedia of Electrical and Electronics Engineering: Retinal Prosthesis John Wiley & Sons, Inc..
[2] Minkenberg, C., Krishnaswamy, R., Zilkie, A. and Nelson, D. (2021), Co-packaged datacenter optics: Opportunities and challenges. IET Optoelectron, 15: 77-91.
作者简介
叶宇,深圳市恒宝通光电子股份有限公司副总经理,博士,主要研究方向为光电子器件及封装技术。
本文地址:http://www.iccsz.com//Site/CN/News/2022/11/30/20221130093503678474.htm 转载请保留文章出处
关键字: 光模块 气密 封装 COB CPO PCB
文章标题:凡事有好有坏,光模块封装技术也不例外
2、免责声明,凡本网注明“来源:XXX(非讯石光通讯网)”的作品,均为转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责。因可能存在第三方转载无法确定原网地址,若作品内容、版权争议和其它问题,请联系本网,将第一时间删除。
联系方式:讯石光通讯网新闻中心 电话:0755-82960080-168 Right
- 设置首页 | 光通讯招聘 | 企业搜索库 | 广告服务 | 联系我们 | 保护私隐 | 公司介绍
Copyright ? 2009 ICCSZ.com Inc. All Rights Reserved. 讯石公司 www.iccsz.com版权所有 粤ICP备12008183号-1
