硅光芯片与电芯片的封装
中国科协发布了2020重大科学问题和工程技术难题,硅光技术榜上有名,“硅光技术能否促成光电子和微电子的融合?”。这篇笔记聊一聊硅光芯片与电芯片的封装方案。
硅光芯片中的调制器和探测器必须与外部的Driver、TIA协同合作,Driver将电信号加载到电光调制器上,TIA将PD处收集到的电流转换为电压信号。如何巧妙地设计封装结构,使得硅光芯片和电芯片之间形成有效的信号互联,成为产业界的一个关注重点。
目前,硅光芯片与电芯片的封装形式主要有四种方式:1) 单片集成,2) 2D封装, 3) 3D封装, 4) 2.5D封装。以下对这些技术方案分别做介绍。
1. 单片集成
所谓单片集成,即在同一个流片平台上,同时加工光器件与电器件,最终的芯片中同时包含PIC和EIC。信号通过芯片内部的金属直接互联。其结构如下图所示,
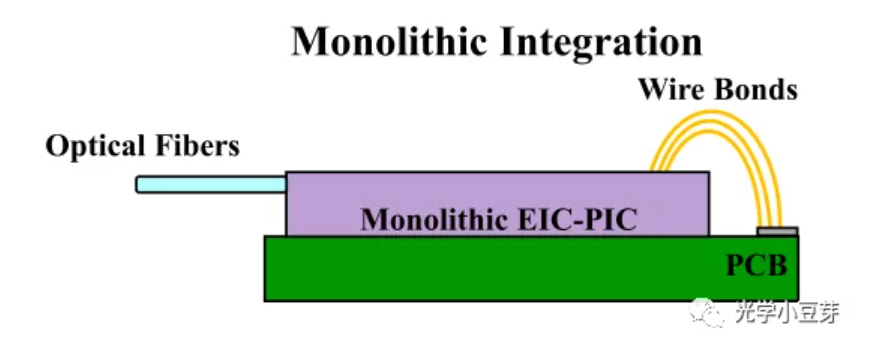
(图片来自文献1)
该方案的优势之一是封装简单,单片集成的芯片只需要通过wiredBond或者flip-chip的方式与PCB板相连即可。目前GlobalFoundry的硅光工艺采用该方案,典型的cross-section如下图所示,在同一层silicon加工NMOS, PMOS和光波导。
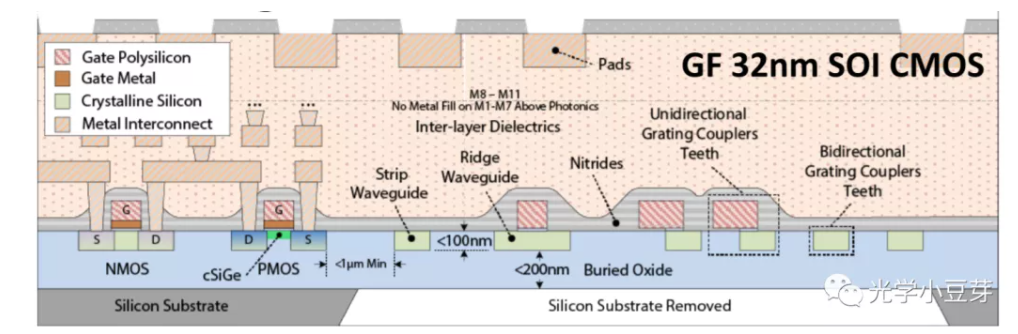
(图片来自 http://www.columbia.edu/~sm4659/AboutPageAssets/materials/24-3_Moazeni_1.pdf)
该方案的主要缺点是,硅光的工艺节点远落后于电芯片的工艺节点,为了单片集成, 得做一些妥协,导致电器件和光器件的性能都达不到最优。光波导的损耗较高、PD的响应率较低,电芯片的功能较大。Luxtera曾经尝试采用该方案,但最终放弃该技术路线,转投TSMC的怀抱,其主要的问题是工艺开发成本高,并且flexibility欠缺。
2. 2D封装
2D封装的方案示意图如下所示,EIC和PIC放在同一个PCB板上,
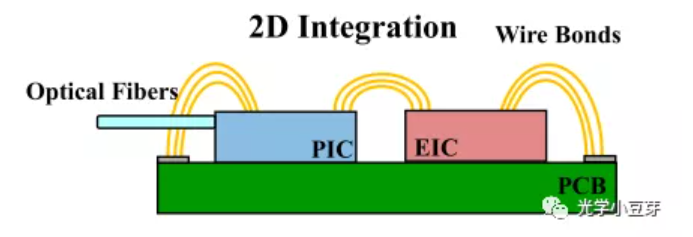
(图片来自文献1)
该方案的一个缺点是EIC与PIC的互联线数目受限(wire bonding只能在PIC与EIC相邻的那条边),因此该方案不适用于高IO数目的应用场景。
Intel在OFC 2019上报道了其采用2D封装的基于微环调制器的发送器,如下图所示,driver的信号通过wire bonding连接到微环调制器上,最终实现了112Gb/s的信号传输速率。
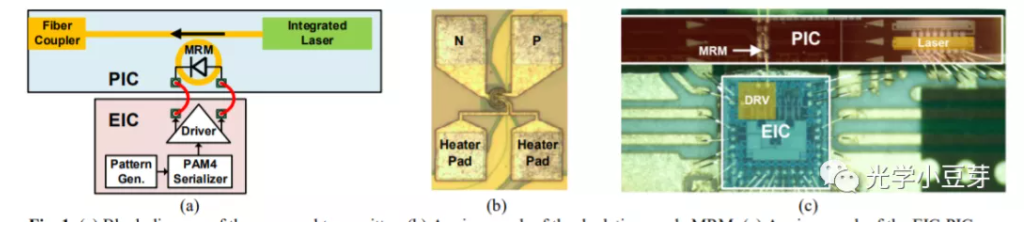
(图片来自文献2)
3. 3D封装
典型的3D封装方案是将EIC倒装在PIC上,EIC和PIC之间通过micro bump或copper pillar互联,PIC通过wire bonding与PCB板相连,如下图所示,
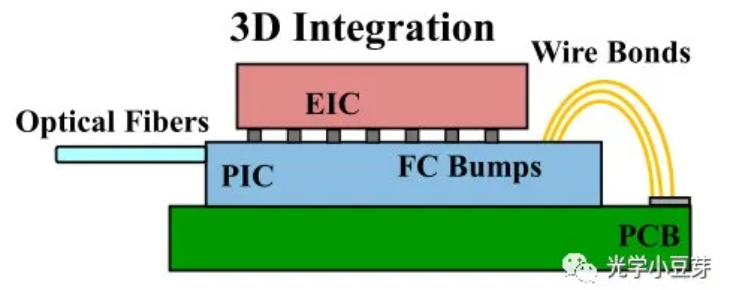
(图片来自文献1)
bump的pitch典型值40-50um,因此EIC和PIC之间可以实现高密度的IO互联,这也是该方案的优点之一。目前绝大多数硅光公司都是采用的该方案。
该方案的缺点之一是散热问题,由于EIC直接堆叠在PIC上方,EIC所产生的热量会传递到PIC上,这会直接影响部分光器件的性能,例如微环。
该方案的一个变体是,在硅光芯片中形成TSV, 通过TSV直接与基板互联,如下图所示,硅光芯片同时作为interposer。
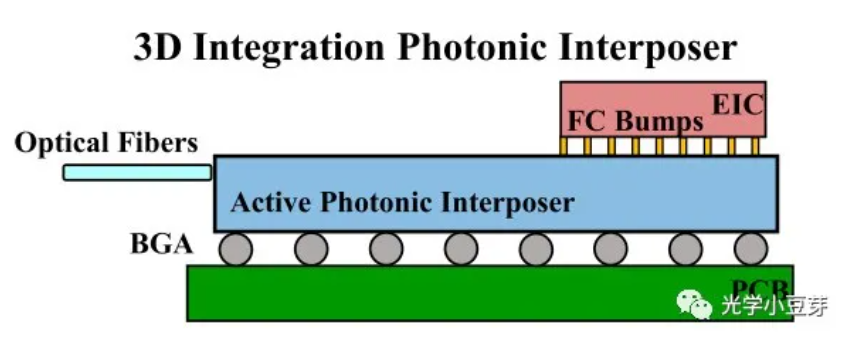
(图片来自文献1)
日本PETRA平台的研究人员在2018年采用该封装方案,实现了16通道的transceiver, 单通道的信号速率为25Gb/s, 其芯片封装结构如下图所示,
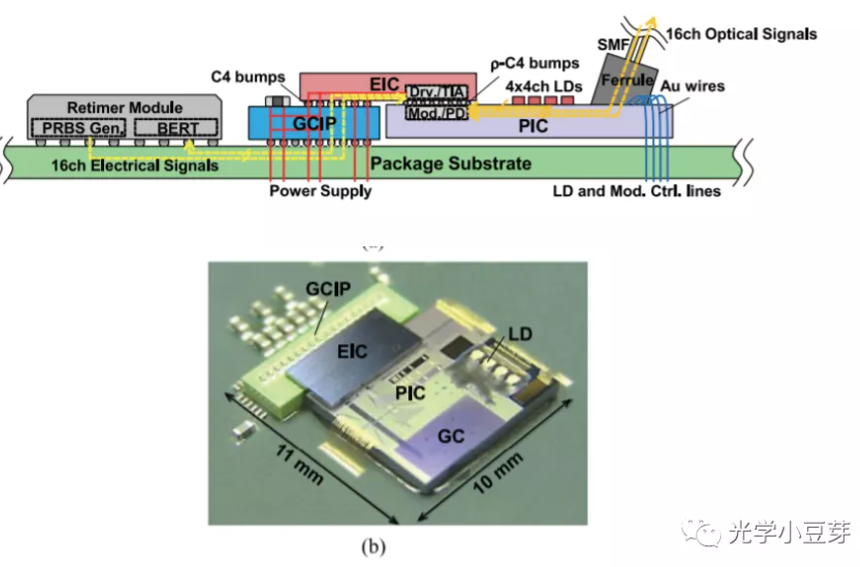
(图片来自文献3)
PIC上不仅仅放置了EIC,还放置了LD, fiber ferrule等, 整个系统的封装较为复杂。
4. 2.5D封装
该方案是将EIC与PIC放在同一个interposer上,interposer通过TSV与基板互联,如下图所示,
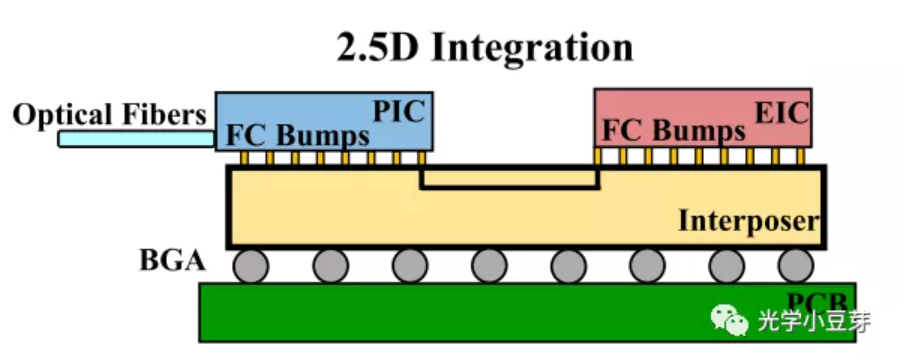
(图片来自文献1)
该方案的优势之一是可以将多个die同时放在一个interposer上,不限于两块芯片,进而构成更复杂更大规模的系统, 如下图所示,
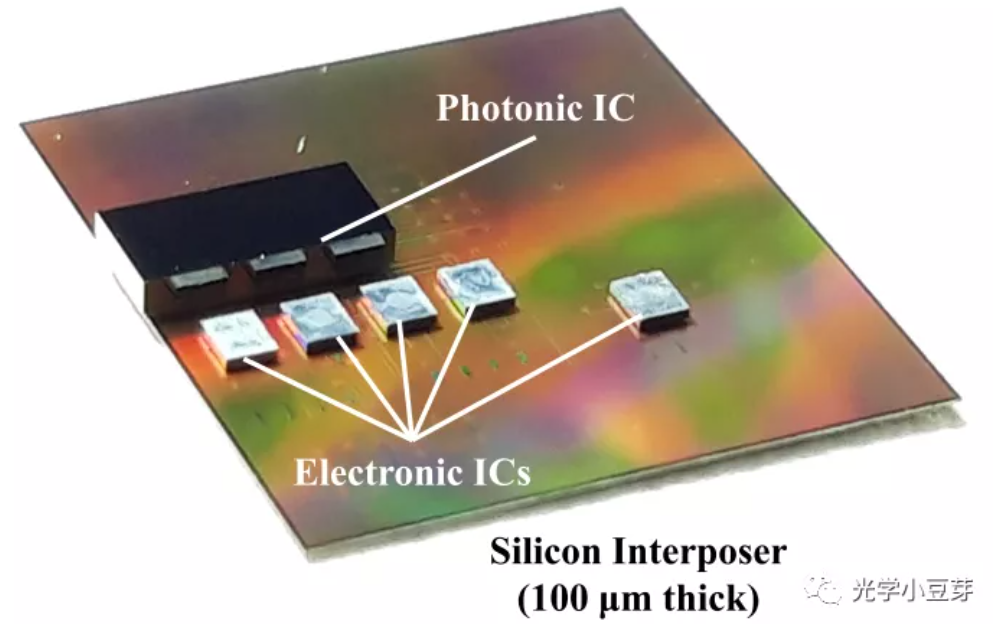
(图片来自文献1)
该方案的缺点之一是EIC与PIC互联的高速信号需要经过两次bump,会对信号的带宽性能产生一定的影响。
以上总结了几种常见的PIC与EIC的封装方案,目前采用3D方案的公司较多。看起来似乎有点像堆积木,但如何实现高IO密度、高信号带宽,很多细节问题需要考量。封装作为产品R&D的最后一步,直接关系到最终产品的良率与成本。由于硅光芯片的特殊性,不能直接采用传统EIC的封装方案,还涉及到光的耦合封装,需要重新开发相关技术,因此封装成本在硅光产品中占有较大比重。
本文地址:http://www.iccsz.com//Site/CN/News/2020/10/31/20201031153819949071.htm 转载请保留文章出处
关键字: 硅光
文章标题:硅光芯片与电芯片的封装
※我们诚邀媒体同行合作! 联系方式:讯石光通讯咨询网新闻中心 电话:0755-82960080-168 Right
- · 北大教授王兴军:硅光市场将迎迅猛发展,更高集成度是重点
- · 硅光助力新基建 | 第三届中国硅光产业论坛即将来袭 欢迎报名
- · 赛勒科技发布单通道100G硅光芯片,瞄准400G数据中心市场
- · MRSI发布为硅光器件、协同封装和晶圆级封装提供亚微米级贴片解决方案
- · 新加坡雨树光科与美国Maxlinear公司共同推出针对数据中心市场 低成本和低功耗的硅光模块解决方案
- · Intel的100G QSFP28 CWDM4硅光模块
- · 解决芯片互连卡脖子问题:CMOS片上光电互连速度突破2Tb/s
- · 国家信息光电子创新中心硅光提案成功入选中国科协2020年度工程难题
- · 硅光技术入选2020年十大工程技术难题
- · 【7.24在线研讨会】先进的测试和自动化加速硅光子技术发展
- 设置首页 | 光通讯招聘 | 企业搜索库 | 广告服务 | 联系我们 | 保护私隐 | 公司介绍
Copyright ? 2009 ICCSZ.com Inc. All Rights Reserved. 讯石公司 www.iccsz.com版权所有 粤ICP备12008183号-1
