深化5G/6G布局 氮化鎵/磷化銦微縮再進化(1)
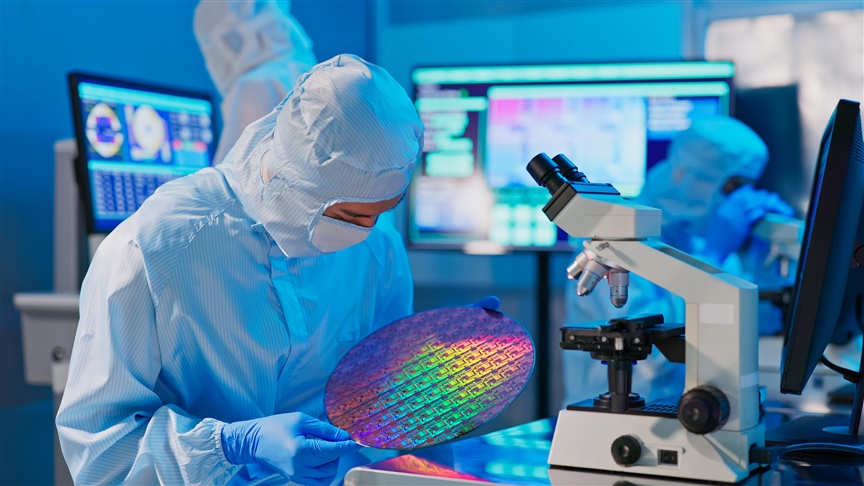
時光荏苒,無線傳輸的資料量與日俱增,使用族群也正不斷擴大。為了趕上這波潮流,並提升資料傳輸的速度與效率,第五代行動通訊系統(5G)現已逐步啟用,業界也著眼未來,展開籌備。5G實現了高達10Gbps的資料傳輸率,而6G預計能在2030年後升級至100Gbps。除了想辦法連結更多的資料與裝置,研究人員也持續探討新一代無線網路如何支援新興應用,例如自動駕駛、全像顯示等。
為了達到這種等級的超高資料傳輸率,電信業不斷提高無線訊號所使用的頻率。5G最初使用6GHz以下的頻段,但主攻28GHz或39GHz的產品已經亮相。介於6~20GHz的第三型頻率範圍(FR3)因為能在覆蓋範圍和流量之間取得平衡,也越來越受到關注。至於6G,目前也在討論100GHz以上的頻段分配。
高頻傳輸有幾項優點,包括開發新的頻段,以及解決現有頻段頻譜有限的問題,並且越往高頻運作,越容易取得更大頻寬。理論上,運用100GHz以上的超高頻段及30GHz以上的頻寬,電信業者就能採用低階調變方法來進行無線資料傳輸,進而降低傳輸功耗。高頻特性也與較短波長(λ)有關。當天線陣列的尺寸隨著λ2變小而持續微縮,封裝就會更加緊湊。這也有助於實現波束成形,該技術能提高送達預定接收器的訊號強度。
不過,高頻運作仍有其弊害。互補式金屬氧化物半導體(CMOS)技術是目前訊號收發器元件的首選製程。這包含了前端模組的功率放大器,這些元件負責發送與接收天線之間的射頻訊號。操作頻率越高,CMOS功率放大器就越難以高效率達到所需的輸出功率。
這時,氮化鎵(GaN)和磷化銦(InP)等技術可以派上用場。這些三五族半導體具備優異的材料特性,因此很可能在高頻操作下滿足對輸出功率和效率的需求。以氮化鎵為例,其電流密度高,電子遷移率高,而且崩潰電壓大,其高功率密度也能實現小尺寸設計,整體系統能在維持性能的同時減少系統尺寸。
在一次模擬試驗中,比利時微電子研究中心(imec)研究團隊比較了三種功率放大器在140GHz操作頻率下的性能表現:CMOS完整設計、CMOS波束成形器搭配矽鍺(SiGe)異質接面雙極性電晶體(HBT),以及單顆磷化銦HBT(圖1)。磷化銦在輸出功率(超過20dBm)及能源效率(20%~30%)方面曾是最佳材料。模擬結果也顯示,磷化銦可在使用較少天線的情況下達到最佳的能源效率。對於尺寸受限的應用,例如行動裝置等用戶設備,這點尤其引人注目。
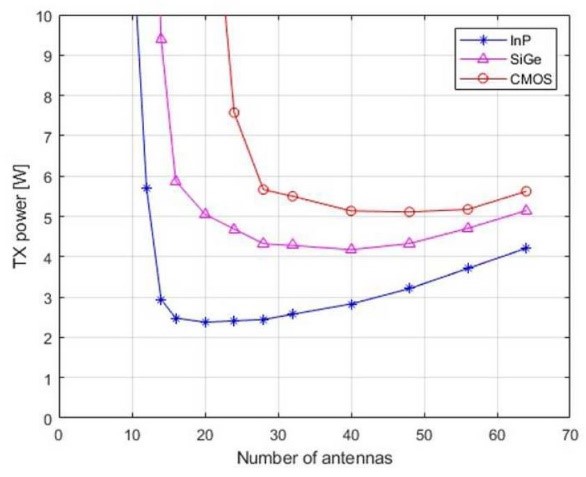
圖1 比較CMOS、矽鍺及磷化銦元件在具備不同天線數量的訊號
發送器中的功耗變化(發表於2022年IEEE國際電子會議)
然而,在較低頻的毫米波方面,氮化鎵展現絕佳性能。根據觀察,採用碳化矽(SiC)基板的氮化鎵HEMT在28GHz和39GHz頻段的輸出功率及能源效率勝過CMOS元件和砷化鎵(GaAs)HEMT。過去研究考量的潛在應用包含由16根天線組成的固定無線接取(FWA)及具備4根天線的用戶設備(圖2)。

圖2、比較採用三種不同技術時,固定無線接取(左)與用戶設備(右)在28GHz及39GHz操作
頻率下的輸出功率(發表於2022年IEEE國際電子會議)
微縮潛力與挑戰
儘管如此,若考量成本和整合難易度,氮化鎵及磷化銦技術目前尚無法與CMOS技術媲美。三五族元件通常使用小尺寸且高成本的非矽基板,量產製程通常較不合用。將這些元件與8吋或12吋矽晶圓整合可以維持優異的射頻性能,同時達到整體最佳化,目前頗受矚目。一方面,矽基板的成本較低;另一方面,與CMOS相容的製程能夠實現量產。
為了在矽技術平台上整合氮化鎵及磷化銦,在設計、材料與製造技術方面,必須結合新興電晶體與電路,其中一大挑戰是嚴重的晶格不匹配。磷化銦(InP)與矽材的不匹配程度為8%,氮化鎵則為17%,導致元件層之間出現大量缺陷,最終折損元件性能。
另外,我們必須讓矽基氮化鎵(GaN-on-Si)及矽基磷化銦(InP-on-Si)元件與CMOS元件共整合於一個完整系統。氮化鎵與磷化銦技術初步將用於前端模組的功率放大器。低雜訊放大器與開關元件也能受益於這些化合物半導體的特殊材料性質,但最後還是需要CMOS技術來進行校正、控制和波束成形。
imec在其先進射頻研究計畫中,攜手業界夥伴探索多種方法,以便在大尺寸矽晶圓上整合氮化鎵及磷化銦元件,並實現與CMOS元件的異質整合。各式應用的優劣分析也納入評估,包含固定無線接取(FWA)等基礎設施以及用戶設備。
改良矽基氮化鎵的射頻性能
依據不同基板,氮化鎵技術包含以下幾種:氮化鎵塊材基板、碳化矽基氮化鎵(GaN-on-SiC),以及矽基氮化鎵(GaN-on-Si)。GaN-on-SiC目前已納入多項研究,並用於5G基地站等基礎設施。比起塊材氮化鎵,GaN-on-SiC的成本效益更高,加上碳化矽具備極佳的熱傳導能力,有助於高功率傳輸的基礎設施排除產生的熱能。然而,碳化矽基板的成本高,且尺寸受限,因此較不適合量產。
相較之下,GaN-on-Si有可能擴大規模,採用8吋甚至是12吋晶圓。多虧了功率電子元件幾十年來的創新,氮化鎵才能在大尺寸矽基板的整合技術方面取得重大進展。但若要達到最佳的射頻性能,還需要進一步改良GaN-on-Si技術。主要挑戰包含達到GaN-on-SiC等級的大訊號功率性能與可靠度,以及提高操作頻率。為此,持續研發創新的堆疊設計、選用不同材料、縮短HEMT閘極長度、抑制寄生現象,以及盡可能避免射頻訊號失真,皆為不可或缺的技術發展。
在imec為射頻元件研發的GaN-on-Si製程中,首先於8吋矽晶圓採用有機金屬化學氣相沉積法(MOCVD)進行磊晶成長。該磊晶結構包含專屬設計的氮化鎵或氮化鋁鎵(AlGaN)緩衝層、氮化鎵通道、氮化鋁(AlN)側壁和氮化鋁鎵阻障層。接著,具備氮化鈦(TiN)蕭特基金屬閘極的氮化鎵HEMT元件在(低溫)後段製程與三層銅材進行整合。
近期,imec在其GaN-on-Si平台首次取得接近GaN-on-SiC的輸出功率與功率轉換效率(PAE),極具競爭優勢(圖3)。功率轉換效率是評估功率放大器的常用指標,其考量功率放大器的增益對整體效率的影響。
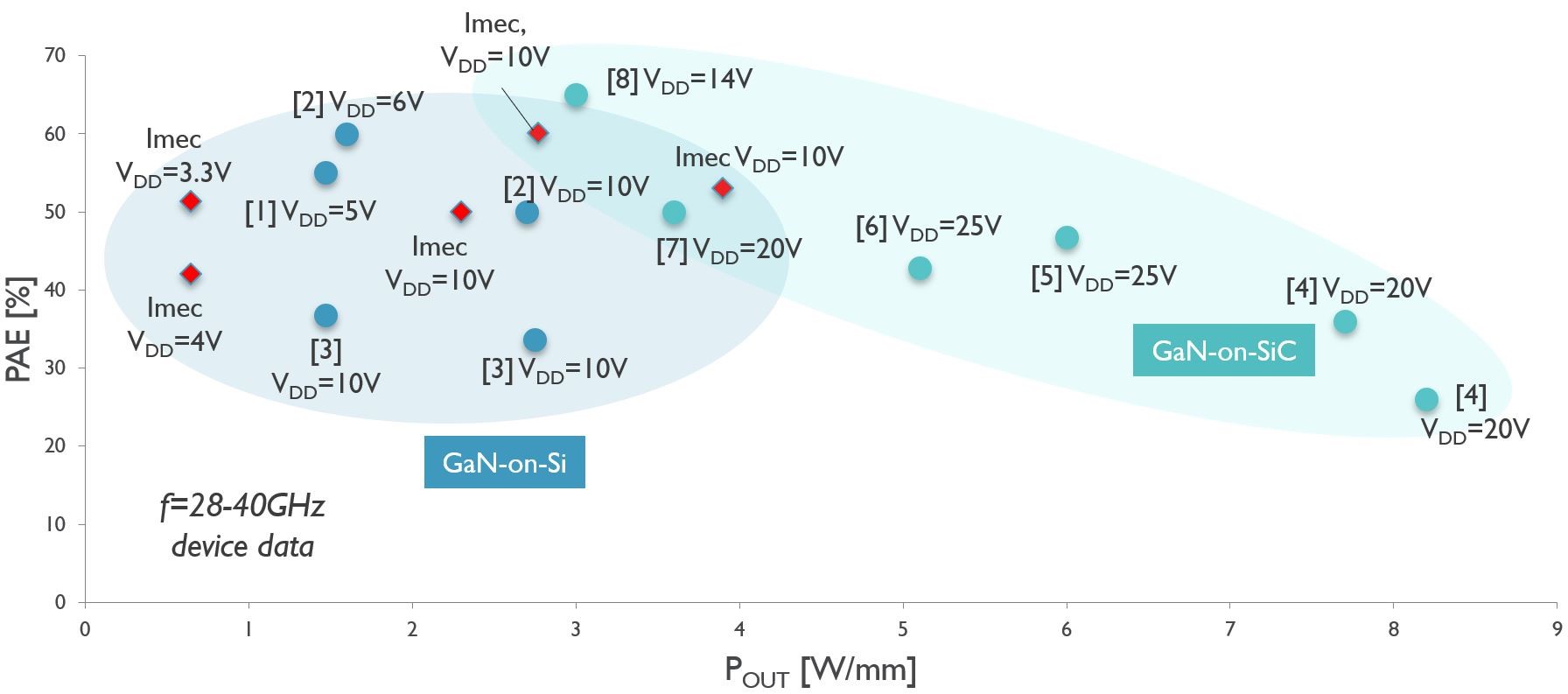
圖3、GaN-on-Si的性能測試數據(發表於2022年IEEE國際電子會議)
(資料來源:[1] H.W. Then et al., IEDM 2020; [2] H.W. Then et al., IEDM 2021;[3] W. Wang et al., J-EDS 2018;[4] Y.C. Lin et al., Micromachines 2020; [5] M. Mi et al., TED 2017;[6] Y. Zhang et al., EDL 2018; [7] K. Harrouche et al., HAL open science, 2020;[8] J.-S. Moon et al., MTTS 2019)
除了技術研發,進行模擬最終也將有助於提升性能與可靠度。舉例而言,imec在2022年IEEE國際電子會議(IEDM)推出了射頻元件的熱傳輸模擬架構。在一項矽基氮化鎵HEMT的研究中,模擬結果顯示,元件的最高溫度比原先預期高了三倍。這類模擬工作能進一步引導如何在研發階段優化射頻元件及其布局。
6G次太赫茲InP-on-Si元件:三種製程方法
如先前展示,不論採用何種製程技術,在140GHz操作頻率下,磷化銦HBT能在輸出功率與效率之間取得最佳平衡。研究團隊也能實現達到最佳射頻性能的元件設計。元件製造部分,通常會從小尺寸(6吋以下)的基板著手,採用具備研究性質的製程,與CMOS並不相容。
但若在這塊矽基板上整合磷化銦元件,性能會有何改變?眾所皆知,在矽基板上沉積磷化銦容易出現大量缺陷,主要為穿隧差排(Threading Dislocation)與面缺陷(Planar Defect)。這些缺陷將誘發漏電流,進而導致元件性能大幅降低或出現可靠度問題。
目前正在考量的微縮製程有三種,其中兩種直接在矽基板上成長磷化銦,最後一種需要經過晶圓重組(圖4)。現有製程使用小尺寸的磷化銦基板,與之相比,這三者的成本效益預計更高,但在性能、成本與異質整合方面各有優缺點。依照不同的應用(包含基礎設施與行動裝置),imec已著手評估各自的發展優勢與技術挑戰。
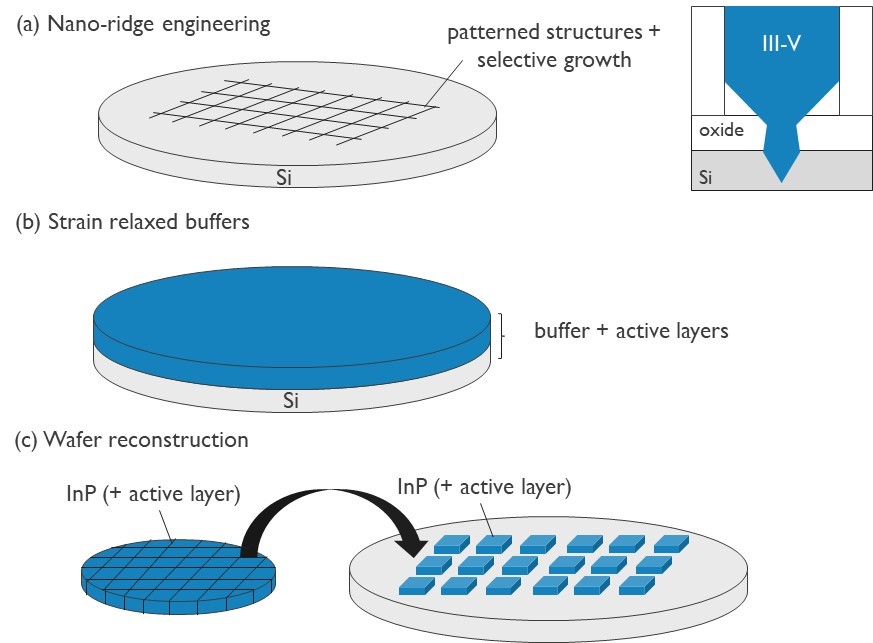
圖4、不同的矽基磷化銦磊晶成長技術:(a)奈米脊工程(b)在空白晶圓磊晶
成長並導入應變鬆弛的緩衝層(c)晶圓重組
第一種矽基磷化銦HBT製程(圖4b)直接在矽基板上沉積應變鬆弛的緩衝層,以彌補矽材與磷化銦晶格不匹配(8%)所帶來的性能損失。接著,直接在緩衝層上成長磷化銦。以更大尺寸的晶圓來製造元件極具成本優勢,尤其是部分矽材還能重複使用。但若要減少缺陷數量,還需進一步研發改良。
撇開這種在「空白晶圓」磊晶成長的做法,imec提出奈米脊工程作為替代製程(圖4a),以更有效的方式解決晶格缺陷問題。奈米脊工程技術在預先圖形化的矽基板上選擇性地沉積三五族材料。這些脊型結構具備高深寬比,能夠有效地把捕獲到的缺陷集中在窄溝底部,還可在溝槽外成長出高品質、低缺陷的材料。奈米脊的構形越往上越寬,頂部可作為元件堆疊的實心基底。先前從砷化鎵(GaAs)、磷化銦鎵(InGaP)研究獲得的研究洞見將能帶領砷化銦鎵(InGaAs)、磷化銦奈米脊HBT元件邁向最佳化設計(圖5、圖6)。
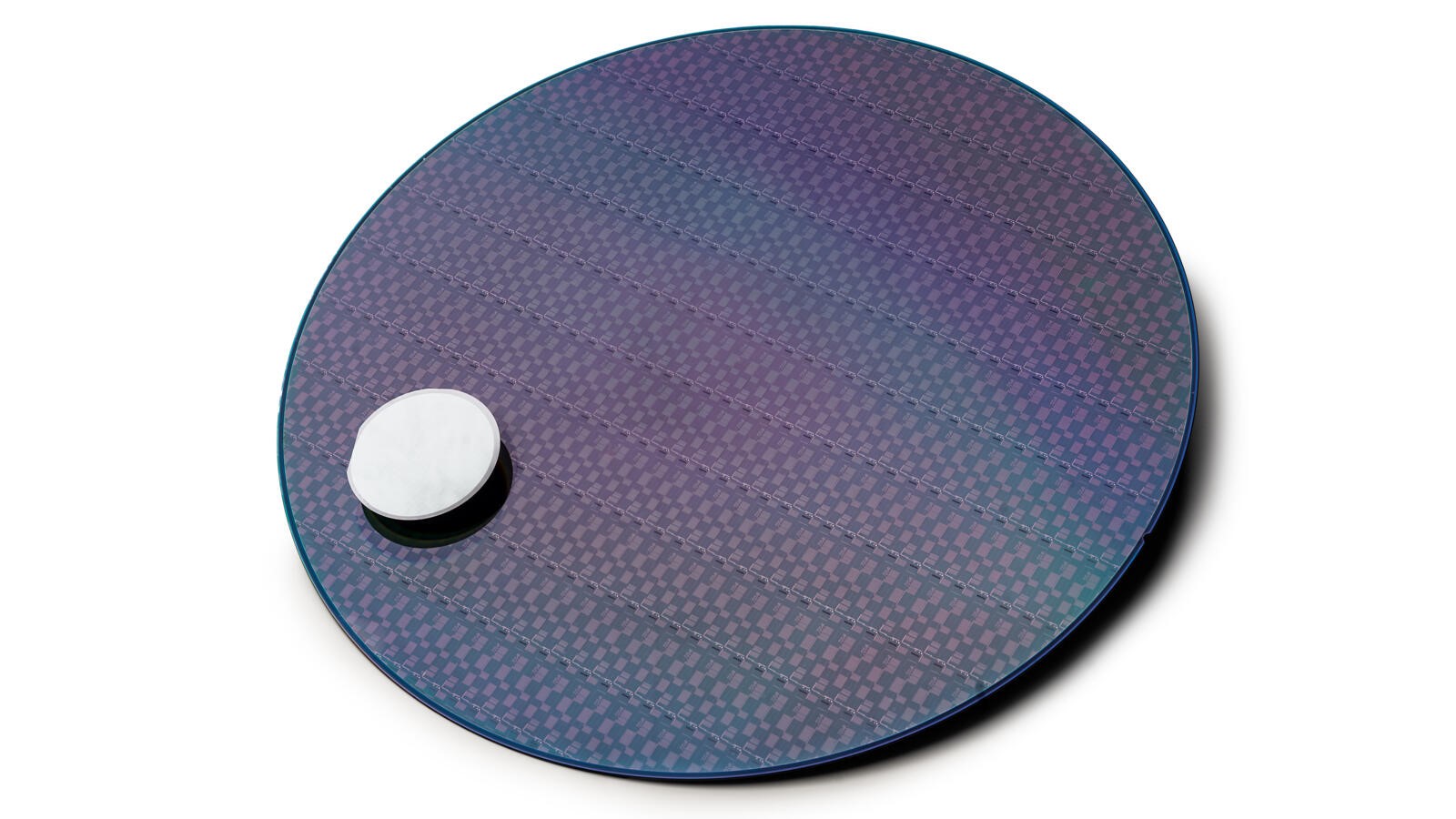
圖5、2吋磷化銦晶圓,以及連接磷化銦奈米脊HBT堆疊的12吋矽晶圓

圖6、12吋晶圓的放大圖,顯示晶粒上帶有奈米脊圖形的磷化銦HBT結構
除了直接進行磊晶成長,磷化銦還能透過晶圓重組與矽晶圓連接。在該製程中,高品質的磷化銦基板不論有無主動層,都會在組成晶圓時分割成不同的方塊。這些方塊隨後以晶粒對晶圓(Die-to-wafer)接合技術與矽晶圓連接。關鍵挑戰在於如何有效轉移材料並移除磷化銦基板,目前正在考量幾種技術以實現這項目標。
邁向異質整合未來
矽基三五族功率放大器最終必須與負責校正與控制的CMOS元件進行整合。imec正在研究多種異質整合方案,權衡各自導入不同應用的利弊。
最常見的射頻元件系統級封裝(SiP)是先進層壓基板(Laminate Substrate)技術,而迎向高頻應用的優化技術如今也處於研發階段。imec也在探索其它先進的異質整合技術,包含2.5D中介層與3D整合技術。
值得注意的是,在100GHz以上的超高頻波段,天線模組將會界定訊號收發器的可用空間範圍。確實,頻率越高波長越短,天線陣列也越來越小。100GHz以上的天線尺寸會比前端模組還小,儘管操作頻率變高,前端模組的尺寸卻難以隨之微縮。關於大型天線陣列的配置,一種有意思的做法是將射頻前端模組移至天線陣列下方。這時就能導入3D整合技術,不論是晶粒對晶圓(Die-to-wafer)接合或是晶圓接合,都能在前端模組與天線模組之間建立明確的短距連接。不過熱管理仍是3D整合的一大問題,開發有效的散熱器將成關鍵。imec現在正進行全面性的系統技術偕同優化(STCO)分析,以評估不同的3D整合技術,並從系統級的視角來影響技術選擇。
手持裝置方面,由於減少天線數量能放寬設計限制,2.5D中介層技術因而備受關注。該異質整合技術運用元件層堆疊,並搭配微影製程的導線,甚至是矽穿孔,以連接三五族元件與CMOS元件。在這種設計下,三五族元件緊鄰CMOS晶片,因為這兩種晶片都能與散熱器直接相接,因此熱管理的成效更佳。不過,這種結構只能進行一維波束掃描(Beam Steering)。現階段,研究人員正在評估2.5D中介層技術的硬體設計,尋找基板、介電材料與重分布層(RDL)的最佳組合,進而降低元件損耗。例如,imec初步展示了鎖定射頻應用的矽中介層技術(圖7),選用傳統的矽基板、半加成法製程(mSAP)的銅導線,以及旋轉塗佈式(Spin-on)的低介電常數材料;這些介電材料在100GHz以上能夠具備極低的導線損耗。
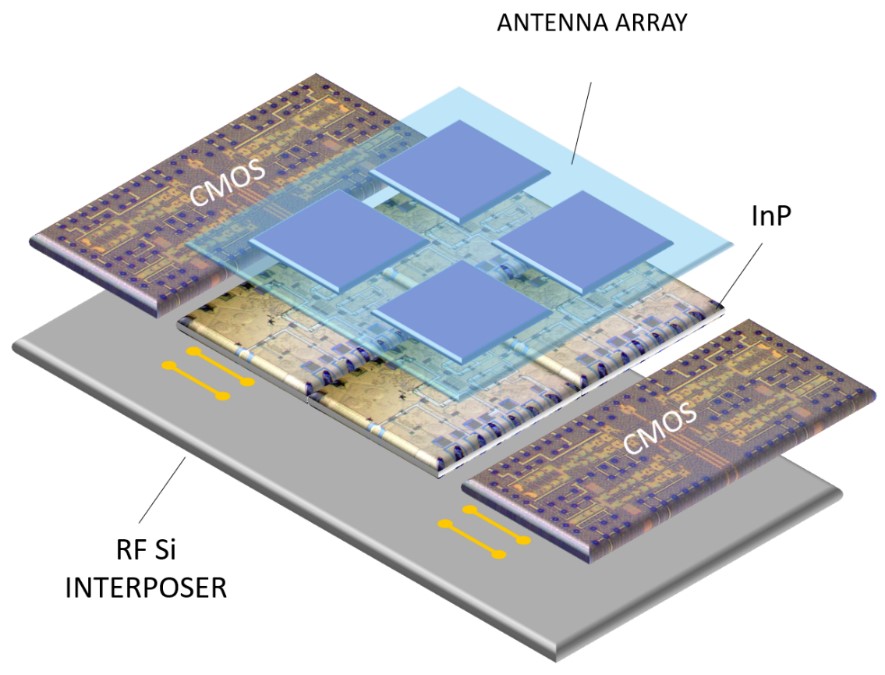
圖7、射頻應用的矽中介層示意圖,磷化銦與CMOS的整合式元件及天線陣列皆在同一封裝內
綜上所述,在微縮化與整合技術方面,近期的研發成果顯示,矽基氮化鎵(GaN-on-Si)與矽基磷化銦(InP-on-Si)有望成為新一代高流量無線網路應用的致勝技術。
(本文作者為imec先進射頻研究計畫主持人)
本文地址:http://www.iccsz.com//Site/CN/News/2023/05/12/20230512070449084242.htm 转载请保留文章出处
关键字: 磷化銦 氮化鎵 5G imec
文章标题:深化5G/6G布局 氮化鎵/磷化銦微縮再進化(1)
2、免责声明,凡本网注明“来源:XXX(非讯石光通讯网)”的作品,均为转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责。因可能存在第三方转载无法确定原网地址,若作品内容、版权争议和其它问题,请联系本网,将第一时间删除。
联系方式:讯石光通讯网新闻中心 电话:0755-82960080-168 Right
- 设置首页 | 光通讯招聘 | 企业搜索库 | 广告服务 | 联系我们 | 保护私隐 | 公司介绍
Copyright ? 2009 ICCSZ.com Inc. All Rights Reserved. 讯石公司 www.iccsz.com版权所有 粤ICP备12008183号-1
