欧洲押注300毫米晶圆异质集成技术争夺半导体主权
ICC讯 对于Fraunhofer IZM-ASSID晶圆级系统集成负责人Manuela Junghähnel而言,半导体主权不仅关乎芯片制造,更在于封装、堆叠与部署能力。在2025年6月17日德国德累斯顿举行的"萨克森硅谷日"活动上,她阐述了欧洲如何通过300毫米晶圆上的3D异质集成技术,重新夺回先进半导体封装领域的战略地位。
在接受《EE Times Europe》独家专访时,Junghähnel揭示了团队如何弥合高端研究与工业应用之间的鸿沟。其背后是一套融合公共资金、顶尖研究与产业化的欧洲创新模式。
构建覆盖AI至量子的本土生态
Fraunhofer IZM-ASSID坐落于前奇梦达工厂旧址,与GlobalFoundries隔街相望,毗邻博世、英飞凌及在建的ESMC超级工厂。这个成立15年的机构专注于300毫米晶圆异质集成——这项技术此前在欧洲尚无工业级应用。
"我们不与大规模晶圆厂竞争,"Junghähnel表示,"而是为需要小批量、高性能系统的企业提供先进封装与3D集成服务。"随着AI推理向边缘端迁移、量子计算需要特殊互连,以及功耗与散热成为芯片关键指标,将传感器、逻辑单元、存储器和光器件紧密集成的能力已具有战略意义。
团队打造了"工业级试验线",核心技术包括硅通孔、微凸块键合和重分布层。Junghähnel强调:"我们引入了全自动化设备、晶圆厂级洁净室和工艺控制系统,这在研究机构中很罕见。"
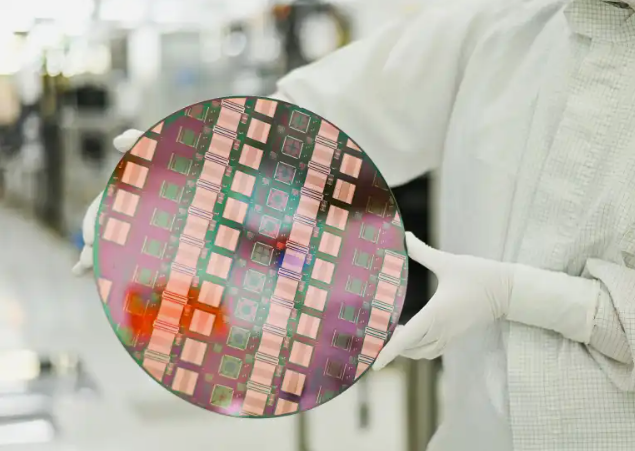
带有流体通道的300毫米硅中介层晶圆(用于主动冷却)(Fraunhofer IZM-ASSID,摄影:Silvia Wolf)
技术路线:从10微米间距到量子低温封装
当前研究重点包括:将互连间距缩小至10微米以下,开发嵌入微腔与直接液体冷却的转接板技术,以及用于超高密度集成的混合键合工艺。在量子计算领域,团队正为德国"QSolid"项目开发可在毫开尔文温度下工作的超导封装方案,旨在用高密度低温互连取代现有数公里长的电缆系统。
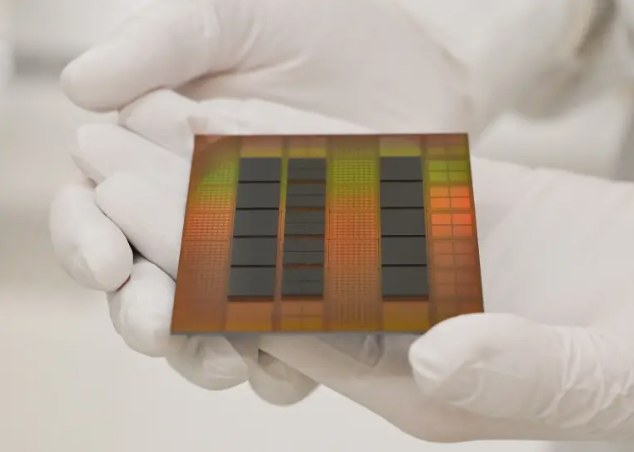
采用10微米间距超细铜混合键合接触的已安装芯片粒(Fraunhofer IZM-ASSID,摄影:Silvia Wolf)
共享基础设施战略
作为《欧洲芯片法案》APECS试验线计划的关键执行方,Fraunhofer IZM-ASSID将投资9500万欧元扩建900平方米洁净室,打造面向初创企业、中小院校的芯片粒系统共享平台。"与其让每个实验室自建300毫米产线,不如集中建设具备工业级可靠性的共享设施,"Junghähnel指出。
相较于新建晶圆厂的宏大宣言,Junghähnel的观点更为深刻:主权不仅需要制造能力,更需掌握从封装到部署的全链条技术。在AI、高性能计算与量子技术的竞赛中,她认为"芯片互连处才是真正的战场"。
这场演讲没有产品发布或政策游说,而是展现了欧洲半导体复兴的底层逻辑:以扎实的工程技术构建持久竞争力。正如Junghähnel所言:"集成不再是瓶颈,而是战略支点。"
原文链接:Europe Bets on Heterogeneous Integration on 300-mm Wafers | https://www.eetimes.eu/europes-strategic-bet-heterogeneous-integration-on-300-mm-wafers/?_gl=1*1wnjzgj*_gcl_au*MzgzNjg2ODEuMTc0NDA3OTI1OQ..*_ga*MTgyNjI4ODkyMS4xNzMyNDk2MTcx*_ga_ZLV02RYCZ8*czE3NTA4OTkzMTEkbzc2JGcwJHQxNzUwODk5MzExJGo2MCRsMCRoMA..
本文地址:http://www.iccsz.com//Site/CN/News/2025/06/26/20250626013155386313.htm 转载请保留文章出处
关键字:
文章标题:欧洲押注300毫米晶圆异质集成技术争夺半导体主权
2、免责声明,凡本网注明“来源:XXX(非讯石光通讯网)”的作品,均为转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责。因可能存在第三方转载无法确定原网地址,若作品内容、版权争议和其它问题,请联系本网,将第一时间删除。
联系方式:讯石光通讯网新闻中心 电话:0755-82960080-168 Right
- 设置首页 | 光通讯招聘 | 企业搜索库 | 广告服务 | 联系我们 | 保护私隐 | 公司介绍
Copyright ? 2009 ICCSZ.com Inc. All Rights Reserved. 讯石公司 www.iccsz.com版权所有 粤ICP备12008183号-1
