中科院:光刻技术得到重大发展
讯石光通讯网 发布时间:2021/6/11 15:44:44 编者:iccsz
摘要:6月10日,中国科学院官网刊文称,上海光机所在计算光刻技术研究方面取得重要进展。
ICC讯 6月10日,中国科学院官网刊文称,上海光机所在计算光刻技术研究方面取得重要进展。
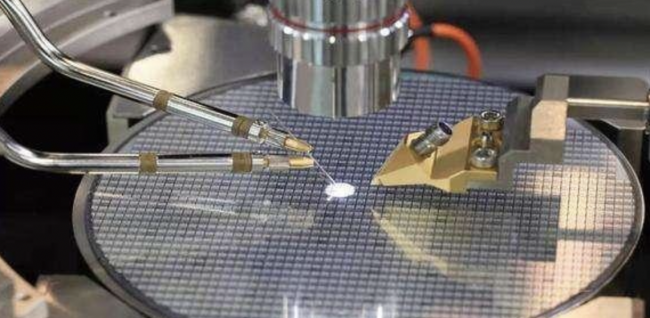
中科院上海光学精密机械研究所信息光学与光电技术实验室,提出一种基于虚拟边(Virtual Edge)与双采样率像素化掩模图形(Mask pixelation with two-phase sampling)的快速光学邻近效应修正技术(Optical proximity correction, OPC)。仿真结果显示,这技术具有较高的修正效率。
随着集成电路图形的特征尺寸不断减小,光刻系统的衍射受限属性导致明显的光学邻近效应,降低了光刻成像质量。
在光刻机软硬件不变的情况下,采用数学模型和软件算法对照明模式、掩模图形与工艺参数等进行优化,可有效提高光刻分辨率、增大工艺窗口,此类技术即计算光刻技术(Computational Lithography),被认为是推动集成电路芯片按照摩尔定律继续发展的新动力。
快速光学邻近效应修正技术(Optical proximity correction, OPC)通过调整掩模图形的透过率分布修正光学邻近效应,从而提高成像质量。基于模型的OPC技术是实现90nm及以下技术节点集成电路制造的关键计算光刻技术之一。
内容来自:集微网
本文地址:http://www.iccsz.com//Site/CN/News/2021/06/11/20210611074606436317.htm 转载请保留文章出处
关键字: 光刻 中科院
文章标题:中科院:光刻技术得到重大发展
本文地址:http://www.iccsz.com//Site/CN/News/2021/06/11/20210611074606436317.htm 转载请保留文章出处
关键字: 光刻 中科院
文章标题:中科院:光刻技术得到重大发展
【加入收藏夹】 【推荐给好友】
1、凡本网注明“来源:讯石光通讯网”及标有原创的所有作品,版权均属于讯石光通讯网。未经允许禁止转载、摘编及镜像,违者必究。对于经过授权可以转载我方内容的单位,也必须保持转载文章、图像、音视频的完整性,并完整标注作者信息和本站来源。
2、免责声明,凡本网注明“来源:XXX(非讯石光通讯网)”的作品,均为转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责。因可能存在第三方转载无法确定原网地址,若作品内容、版权争议和其它问题,请联系本网,将第一时间删除。
联系方式:讯石光通讯网新闻中心 电话:0755-82960080-168 Right
2、免责声明,凡本网注明“来源:XXX(非讯石光通讯网)”的作品,均为转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责。因可能存在第三方转载无法确定原网地址,若作品内容、版权争议和其它问题,请联系本网,将第一时间删除。
联系方式:讯石光通讯网新闻中心 电话:0755-82960080-168 Right
- 设置首页 | 光通讯招聘 | 企业搜索库 | 广告服务 | 联系我们 | 保护私隐 | 公司介绍
Copyright ? 2009 ICCSZ.com Inc. All Rights Reserved. 讯石公司 www.iccsz.com版权所有 粤ICP备12008183号-1
